微米缝缺陷检测
1-采用我司设备和进口设备同时进行检测;
2-我司设备可准确观测微米缝内精细结构缺陷。

微米缝缺陷检测图: 进口设备1,2,3阶太赫兹近场检测图 ( 左上/左中/ 左下) , 我司设备4,5,6阶太赫兹近场检测图 ( 右上/右中/右下)
随着信噪比提升 ,我司设备可提供更高阶次的太赫兹近场成像 ,呈现更多细节信息
半导体失效痛点分析:
1-缺乏 — 种直接有效手段查明失效原因;
2-现有手段: 光学成像EMMI&OBIRCH、 电镜+逐层剥离、 TDR;
3-速度慢 , 有损检测。
太赫弦优势:
1-高频信号判断失效点;
2-穿透半导体材料 , 可以分析深层问题;
3-半导体载流子输运在太赫兹频段。
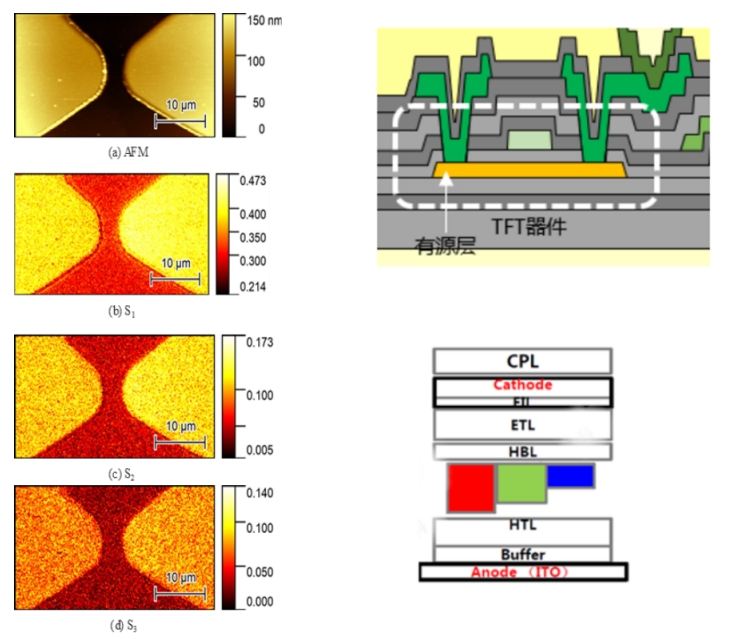
微型缺陷结构点检测: 狭缝检测的原子力形貌图和太赫兹近场图(左) , 半导体缺陷类型 ( 右)